多层电路板制作必须要经过压合这一个步骤,压合动作包括在各层间加入绝缘层将彼此黏牢。多层电路板比双面电路板多了压合的工艺,多层电路板在压合过程中会遇到很多问题,例如起泡问题,内层图形位移问题,层间错位,板翘问题等。多层电路板在叠层结构设计中考虑的主要因素是材料的耐热性、耐电压、填胶量以及介质层厚度等,应遵循以下主要原则。
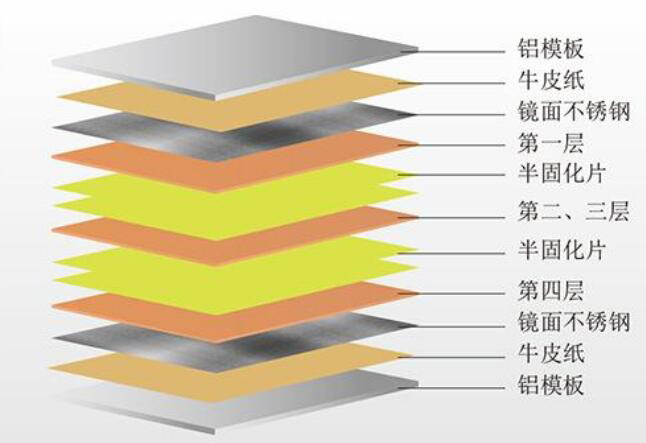
1. 半固化片与芯板厂商必须保持一致。为保证PCB可靠性,所有层半固化片避免使用单张1080或106半固化片(客户有特殊要求除外),客户无介质厚度要求时,各层间介质厚度必须按IPC-A-600G保证≥0.09mm。
2. 当客户要求高TG板材时,芯板和半固化片都要用相应的高TG材料。
3. 内层基板3OZ或以上,选用高树脂含量的半固化片,如1080R/C65%、1080HR/C 68%、106R/C 73%、106HR/C76% ;但尽量避免全部使用106 高胶半固化片的结构设计,以防止多张106半固化片叠合,因玻纤纱太细,玻纤纱在大基材区塌陷而影响尺寸稳定性和爆板分层。
4. 若客户无特别要求,层间介质层厚度公差一般按+/-10%控制,对于阻抗板,介质厚度公差按IPC-4101 C/M级公差控制,若阻抗影响因素与基材厚度有关,则板材公差也必须按IPC-4101 C/M级公差。

评论列表